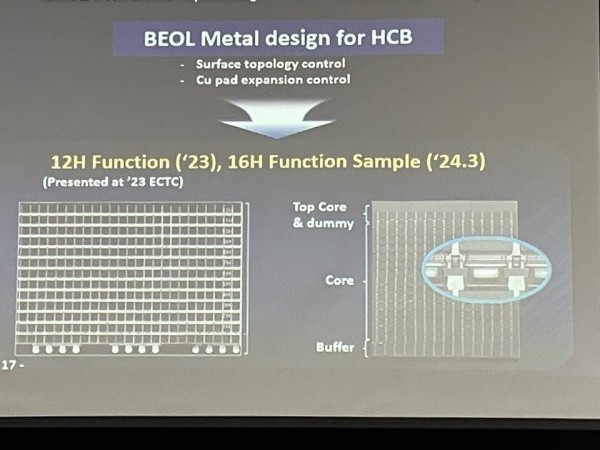
三星电子高级封装团队的高管Dae Woo Kim近日在2024年度韩国微电子与封装学会年会上表示,该公司成功制造了采用16层混合键合技术的HBM3内存样品,并且该内存工作正常。他表示,未来16层堆叠混合键合技术将用于HBM4内存量产。
相比之下,现有键合工艺需要在DRAM内存层间添加凸块,而混合键合则将上下两层直接铜对铜连接,显著提高了信号传输速率,适应了AI计算对高带宽的需求。此外,混合键合还能降低DRAM层间距,进而减少HMB模块整体高度。
然而,混合键合也面临着成熟度不足和应用成本昂贵等问题。因此,三星电子在HBM4内存键合技术方面采取了两条腿走路的策略,同时开发混合键合和传统的TC-NCF工艺。据悉,在775微米的高度限制放宽后,有助于继续使用TC-NCF工艺。
Dae Woo Kim还回应了关于TC-NCF技术存在的质疑。他表示,三星电子的方案相较于竞争对手SK海力士的MR-RUF更适用于12层乃至16层的高堆叠模块。





發表評論 取消回复