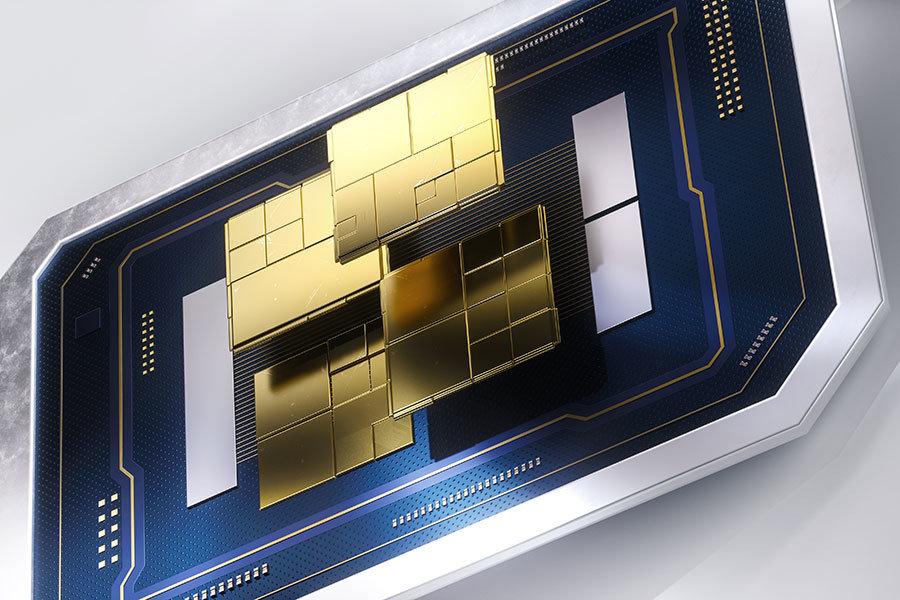
集微網消息,據外媒EE Times報道,英特爾正在研發玻璃材質的芯片基板,以解決目前有機材質基板用於芯片封裝存在的問題。英特爾裝配和測試主管Pooya Tadayon表示,玻璃的硬度優於有機材質,並且熱膨脹系數低,不像有機基板那樣會發生膨脹和彎曲。這些特性使得玻璃基板有很大優勢,可以降低連接線路的間距,適用於大尺寸封裝。
Tadayon提到,使用玻璃材料可以實現一些有趣的特性,能夠提高芯片供電效率,並且使得連接帶寬從224G提升至448G。隨著制造工藝的發展和需求變化,玻璃基板將逐漸出現,並與有機材質基板共存,而不是取代後者。
英特爾技術開發副總裁兼封測開發總裁Tom Rucker表示,在先進封裝方面,英特爾已經從SoC(片上系統)過渡到瞭system-in-package晶圓級封裝。這一轉變在積極進行中,目前已經有許多產品應用瞭EMIB(嵌入式多芯片互聯橋接)技術,現在正向3D互聯轉變,支持芯片堆疊,這樣可以使得同樣的面積內得到更高的性能。
不過,隨著大尺寸封裝的出現,機械方面的挑戰也隨之而來。英特爾表示,大尺寸封裝的基板往往會翹起,這使得裝配到主板上會變的很困難,所以如果有更先進的封裝技術,可以幫助到客戶,同時英特爾會與電路板組裝公司合作。
英特爾稱,預計玻璃基板封裝的芯片最早可在2024年年底前生產,連接間距會在將來逐漸縮短,並支持3D堆疊。這種封裝技術還可以明顯提高良品率,因為如今的大型數據中心GPU、加速器,使用瞭小芯片封裝技術,一片基板上最多可封裝多達50顆芯片,隻要有一顆封裝不良,那麼整片就要報廢。
(校對/張傑)





發表評論 取消回复